2024半导体材料行业报告:CMP技术与国产化替代趋势
1、鼎龙股份:快速发展的泛半导体材料平台型企业
1.1、国内打印复印材料龙头企业,大力布局半导体材料
深耕光电成像显示及半导体工艺材料领域,致力打造成核心材料创新型平台公司。鼎龙股份成立于2000年,2010年在创业板上市,2013年开始研发CMP抛光垫产品并且收购珠海名图启动PI研发项目,又于2017年开启CMP抛光液研发项目。目前重点聚焦于半导体创新材料领域中,具体包含半导体制造用工艺材料、半导体显示材料、半导体先进封装材料三个细分板块,并持续在其他相关应用领域的创新材料端进行拓展布局,是国内CMP抛光垫和打印耗材的龙头企业,已发展成为湖北省、长三角、珠三角等三地区产研布局的企业集团。
公司重点布局半导体材料,同步实现打印复印耗材全产业链布局。在光电半导体材料板块中包含半导体CMP制程工艺材料、半导体显示材料、半导体先进封装材料三大领域。
细分来看,在半导体CMP制程工艺材料领域,公司围绕集成电路前段制程中的化学机械抛光环节进行布局,是国内唯一一家全面掌握CMP抛光垫全流程核心研发技术和生产工艺的CMP抛光垫供应企业,且多线布局铜、钨、介电层等抛光液产品。
在半导体显示材料领域,公司自研自产的PI、PSPI已在客户端销售,TFE-INK正在持续开发、验证中。
在半导体先进封装材料领域,公司积极布局临时键合胶TBA以及封装光刻胶PSPI两大产品,前者客户验证及量产导入工作基本完成,后者已完成客户端送样,产品仍在持续验证中。
在传统打印复印耗材板块中,公司先后布局开发出彩色聚合碳粉、显影辊等关键原材料,形成了全产业链经营模式,以下游产品硒鼓、墨盒带动上游材料销售,是全球激光打印复印通用耗材生产商中产品体系齐全的领先企业。
1.2、公司营业收入快速增长,CMP抛光垫占比日益提升
公司营业收入持续增长。公司营收由2016年的13.06亿元上升至2022年的27.21亿元,CAGR为13.01%。2023Q1-Q3公司实现营业收入18.73亿元,同比-4.24%,归母净利润1.76亿元,同比-40.21%。2023Q1-Q3公司收入小幅下滑的原因主要为抛光垫下游需求阶段性萎靡,同期归母净利润下滑的原因主要为公司加大研发投入所致。随着CMP抛光垫下游需求逐步回暖,预计公司业绩环比有望持续改善。
自2020年开始,公司CMP抛光垫营收占比持续上升,业务结构逐步朝着高端化转型。2018-2023H1年公司CMP抛光垫营收占比分别为0.22%、1.04%、4.35%、13.03%、19.18%、19.48%,从2020年开始营收占比逐步上升。展望未来,随着公司抛光垫产能的加速释放和其余半导体材料客户验证进度的推进,包括CMP抛光垫在内的泛半导体材料收入有望持续提升,助力公司完成业务结构的高端化转型。
公司毛利率基本保持稳定,CMP抛光垫的毛利率相对较高。2023Q1-Q3公司毛利率和净利率分别为35.78%和11.70%,相比于2022年的38.09%和16.69%,毛利率和净利率均有一定程度下滑。毛利率的小幅下滑主要是CMP抛光垫的收入下滑导致的高毛利业务占比有所降低导致,净利率下滑主要是费用有所提升。随着抛光垫下游需求的回暖和其余半导体材料的放量,我们预计未来公司总体毛利率依旧存在提升空间。
公司研发投入力度较大,整体期间费用维持合理水平。公司2023Q1-Q3研发支出2.77亿元,占营业收入比15%,重点发展半导体相关业务,主要集中于CMP抛光垫、抛光液、PSPI光刻胶、YPI材料以及封装材料等项目。公司期间费率维持合理水平,2023Q1-Q3销售、管理(含研发)、财务费率分别为4.87%、22.42%、-0.32%。
2、半导体材料:全球晶圆厂设备投资复苏叠加下游库存去化,半导体材料需求上行
半导体材料贯穿芯片加工全过程,是产业链的重要一环。根据在产业链中应用环节的不同,半导体材料可划分为前端晶圆制造材料和后端封装材料。其中,晶圆制造材料主要包括硅片、掩膜版、电子特气、光刻胶、工艺化学品、研磨液、靶材等,封装材料主要包括引线框架、封装基板、陶瓷材料、键合金丝、切割材料等。作为贯穿整个芯片加工全过程的核心原材料,半导体材料是整个产业链中极其重要的一环。从需求端的角度,中长期来看,半导体材料需求主要受到下游终端景气度、相关设备投资额和增速的影响。短期来看,下游稼动率和库存情况对其需求扰动较大。
从全球的角度来看,2024年全球晶圆厂设备投资回暖,有望带动相关材料需求。根据SEMI2023年12月12日发布的《年终总半导体设备预测报告》中的数据,2023年全球晶圆厂设备支出将同比-4%,从2022年的941亿美元的历史高位降至905.9亿美元,此次设备投资额降低主要源于半导体市场的周期性收缩。但是,至2024年,SEMI预计全球晶圆厂设备投资将回暖至931.6亿美元,同比+3%。随着全球晶圆厂设备投资额的回升,有望带动全球集成电路相关材料需求增长。
从区域的角度来看,我国半导体设备投资连续多年蝉联榜首。根据SEMI的数据,2020年中国大陆半导体设备投资额为187.2亿美元,占当年全球半导体设备投资额的26%,排名全球第一,首次超过中国台湾地区。2021年,中国大陆半导体设备投资额再一次创下历史新高,全年投资额达296.2亿美元,较2020年增长58.23%,全球投资额占比也由2020年的26%上涨至29%,蝉联全球第一。2022年,虽然中国大陆半导体设备投资额同比小幅下滑至287.2亿美元,但全球投资额占比依旧维持首位。
设备投资落地拉动晶圆产能扩张,我国规划新增晶圆厂数量全球第一,国产半导体材料空间广阔。根据SEMI统计数据显示,2021-2023年,全球半导体行业将新建84座大规模芯片制造工厂。其中中国大陆三年内计划新建20座晶圆厂,排名世界第一。美洲紧随其后,在《芯片和科学法案》推动下,从2021到2023年,预计美洲地区将新增18座晶圆工厂,这些新建的晶圆厂以12寸(300mm)晶圆生产为主。从区域来看,预计中国大陆300mm晶圆市场份额在2026年将达到全球第一。根据SEMI统计数据显示,2022年中国大陆300mm前端晶圆厂产能市场份额为22%,根据目前的产能规划推测,至2026年,该比例将提升至25%,超越韩国成为全球第一。随着越来越多的国内晶圆厂产能落地,从保障供应链安全和降低成本双重角度出发,国产半导体材料的应用比例将快速增长,市场空间广阔。同时,从扩产结构来看,基本以12英寸先进制程产线为主,这对半导体材料的品质提出了更高的要求,半导体材料行业高端化趋势显著。
短期来看,下游半导体厂商库存端稳定去化。2023Q4全球主要半导体厂商平均库存周转天数约为135天,已经连续三个季度回调。虽然整体库存仍处于较高水平,但从头部厂商的库存变化可以看出,2023年全球半导体产业趋势向好。从国内半导体材料库存情况来看,2023Q3我国半导体材料行业平均库存金额为10.31亿元,较2023Q2有所提升。但是2023Q3国内半导体材料厂商平均库存周转天数下降至135天,略低于2023Q2的139天,库存也处于稳定去化中。
2023Q3全球前十大晶圆代工厂库存天数走势分化。其中格芯、台积电、中芯国际的库存周转天数较2023Q2出现上升,分别为97.04、94.16、83.15、163.75天;华虹半导体、世界先进的库存周转天数较2023Q2有所下降,分别为135.09、81.31天。
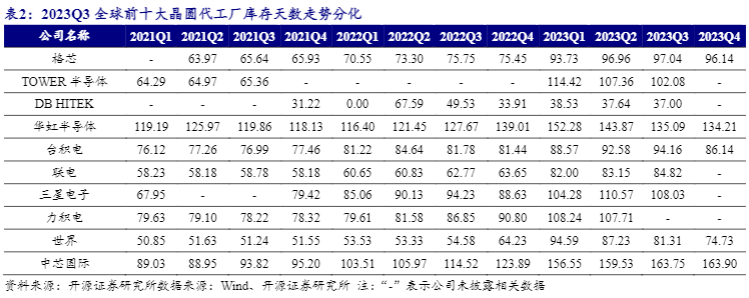
全球晶圆代工厂(不含IDM)平均产能利用率触底回升。根据群智咨询的统计数据,2023Q4全球纯晶圆代工(不含IDM)平均产能利用率约为74%,较2023Q3下滑9pcts。群智咨询预测,2024Q1平均产能利用率将环比小幅增长1-2 pcts,并预计有望在2024Q4回升到87%。
全球半导体材料市场规模稳健增长,中国增速快于全球。根据SEMI公布的数据,2022年全球半导体材料的市场规模为726.9亿美元,同比+8.86%,2016-2022年均复合增速为9.22%,呈现稳健增长格局。2022年中国半导体材料市场规模为129.7亿美元,同比+7.35%,2016-2022年均复合增速为11.36%,高于同期全球增速。
2.1、CMP是半导体先进制程中必不可少的关键工艺,公司全方位布局抛光垫和抛光液
化学机械抛光(ChemicalMechanicalPolishing,CMP)是一种用于处理硅晶圆或其他衬底材料的表面平坦化技术。CMP设备包括抛光、清洗和传送三个模块。在抛光过程中,抛光头将晶圆的待抛光面与粗糙的抛光垫接触,并通过让研磨液填充在研磨垫的空隙中,使圆片在研磨头的带动下高速旋转,与研磨垫和研磨液中的研磨颗粒相互作用,实现全局平坦化。由于当前集成电路元件采用多层立体布线,因此集成电路制造的前道工艺需要进行多次循环,并且随着芯片尺寸的减小,对表面平整度的要求也越来越高。在这个过程中,CMP技术是实现晶圆表面平坦化的关键工艺,也是推进集成电路制造中工艺节点升级的重要环节。
CMP超越传统平面化技术,是目前几乎唯一的可以提供全局平面化的技术。CMP技术最早出现在1965年,当时提出了以二氧化硅为抛光浆料的CMP技术。在此之前,半导体基片的抛光主要以机械抛光为主,采用诸如氧化镁、氧化锆等机械抛光方法,得到的表面损伤极其严重。而运用CMP硅片平坦化技术能够极大的提高抛光精度、抛光速率和抛光破坏深度等方面,而且加工方法简单,成本低廉,也是目前几乎唯一能够实现全局平坦化的技术。
CMP在硅片制造、前道工艺以及后道工艺中均有应用,其中集成电路制造是CMP工艺的主要应用场景。在硅片制造环节中,经过刻蚀、离子注入等工艺后,硅片表面会出现不平整和多余的表面物质,通过CMP来实现硅片表面的平坦化。在集成电路制造过程中,CMP主要用于多层立体布线中的平坦化,确保各层之间的良好连接和信号传输。在封测环节中,CMP工艺被广泛应用于先进封装领域,包括硅通孔(TSV)技术、扇出(Fan-Out)技术、3DIC等都将用到大量CMP工艺。
CMP抛光步骤随着晶圆制造技术进步而不断增加,CMP抛光材料用量也与晶圆芯片制程变化高度相关。逻辑芯片方面,14纳米以下逻辑芯片要求的CMP工艺将达到21步,使用的抛光液将从90纳米的五六种抛光液增加到二十种以上,使用种类和用量都迅速增长;7纳米及以下逻辑芯片工艺中CMP抛光步骤将会达到30步及以上,使用的抛光液种类接近三十种。存储芯片方面,在由2DNAND向3DNAND发展的过程中,抛光步骤从7步提升到了15步,提升了两倍之多,并且3DNAND堆叠层数也会带动CMP抛光材料的需求。
先进封装的应用使CMP从晶圆制造前道工艺走向后道工艺。在封装领域,传统的2D封装并不需要CMP工艺,但随着系统级封装等新的封装方式的发展,出现了倒装、凸块、晶圆级封装、2.5D封装和3D封装等先进封装技术。其中TSV技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互连,是实现芯片之间互连的最新技术,也是继线键合(Wire Bonding)、TAB和倒装芯片(FC)之后的第四代封装技术。并且由于TSV技术中需要将CMP工艺用于TSV背面金属的露出,为背面互连的加工做好准备,故将CMP从前道工艺带入到了后道工艺之中,进一步加大了CMP抛光材料的需求。
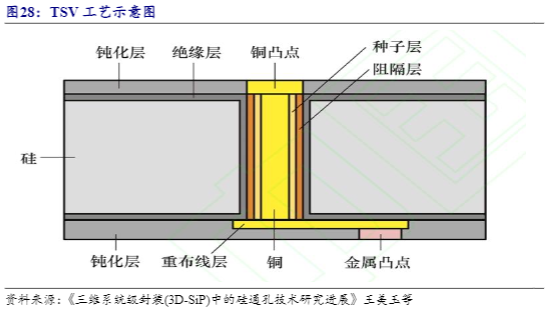
在CMP材料中,抛光垫与抛光液市场份额占比总和超过80%,价值最高。根据SEMI统计,在晶圆制造材料中,CMP抛光材料份额占比7.1%。而CMP抛光材料又包括抛光液、抛光垫、调节剂、清洗剂以及其他添加剂,其中抛光液和抛光垫分别占据CMP材料49%和33%的市场份额。其次为调节剂和清洗液,主要用于去除残留在晶圆表面的微尘颗粒、有机物、无机物、金属离子、氧化物等杂质。
2.1.1、抛光垫:CMP实现平坦化的核心部件,公司是国内抛光垫领军企业
抛光垫是CMP实现平坦化的核心部件。抛光垫是一种柔软疏松的材料,一般由聚氨酯、聚乙烯构成,其表面通常有许多小孔,可以容纳抛光液。抛光垫的作用主要有存储和运输抛光液、排出抛光过程中产生的废物、去除机械负荷保证抛光的平稳进行。抛光垫的参数指标,如材质硬度、弹性、压缩比等都起到重要作用,同时,其表面结构和表面粗糙度可通过影响抛光液流动和分布,来影响抛光效率和平坦性指标。
抛光垫品类丰富。抛光垫根据是否含有磨料可分为磨料抛光垫以及无磨料抛光垫;根据基材可分为聚氨酯抛光垫、无纺布抛光垫和复合型抛光垫,其中聚氨酯抛光垫为目前主流的抛光垫种类,它的聚合物对抛光面适应性好、种类多因而加工性好、成本较低,但是聚氨酯垫片硬度高,适合粗抛;根据表面结构可分为平面型抛光垫和网格型抛光垫。

本文仅供参考,不代表我们的任何投资建议。如需使用相关信息,请参阅报告原文。