2024年半导体封装行业趋势分析报告
1ASMPT:全球封装设备龙头
1.1公司简介:半导体封装+SMT两大业务板块
ASM Pacific Technology(ASMPT)成立于中国香港,总部位于新加坡。公司目前主营半导体封装设备和SMT(Surface Mount Technology,表面贴装技术)设备业务,其产品包括晶片沉积和激光开槽,包括各类精密电子和光学元件塑造、组装和封装为包括电子、移动通信、计算技术、汽车、工业和LED(显示器)终端用户设备的解决方案,是全球唯一家为电子制造过程所有主要步骤提供高质量解决方案的公司。
ASMPT大股东荷兰ASMI(ASM international)为半导体前道薄膜设备全球龙头,深耕行业多年,1975年,ASMI在中国香港投资设立ASMPT,截至2023年报,ASMI持有公司24.85%股份。
在半导体(SEMI)封装业务板块,公司产品主要用于传统集成电路/分立器件封装(例如引线键合设备、倒装键合设备)、先进封装(例如热压键合设备、混合键合设备、物理气相沉积/电化学沉积设备、激光切割/开槽设备),以及用于CMOS图像传感器/LED/光子学的综合性封装解决方案。
在SMT业务板块,公司产品主要用于SIPLACE贴装解决方案、DEK印刷解决方案、检测和存储解决方案、智能车间管理套件WORKS等软硬件产品。
1.2业绩短期承压,半导体业务率先启动复苏
受到半导体行业正处于下行周期和市场对消费电子设备的需求下降的影响,公司近三年业绩有所下降。2023全年公司实现营收146.97亿港元,YOY-24.1%,24Q1公司实现营收31.39亿港元,YOY -19.88%。利润端,得益于产品领先的市场地位,公司在行业下行周期保持了较为稳定的毛利率表现,2023年毛利率39.28%,同比下滑1.86 pct,24Q1恢复至41.88%。但收入端的压力和固定费用支出带来费用率增长,净利率下滑,24Q1公司实现净利润1.8亿港元,YOY -43.4%。
分业务板块来看,SEMI业务板块下游较早的步入下行周期,SMT收入规模整体较为稳定。但从订单侧,SEMI板块在23Q4以来较早的启动复苏。
2023全年SEMI业务板块收入63.65亿港元,YOY -37%,占公司总营收的43.82%,SMT业务板块收入83.32亿港元,YOY -10%,占公司总营收56.18%。公司的两个业务分部有着不同的周期,在一定程度上帮助集团抵御其中某个分部下行周期对公司整体业绩的产生的不利影响。
订单侧,2023全年公司SEMI板块订单53.4亿港元,占比43.56%,SMT板块订单69.19亿港元,占比56.44%。值得注意的是,SEMI板块订单在23Q4实现触底反弹,在23Q4-24Q1连续两个季度实现同比正增长,而SMT板块复苏相对平缓,在24Q1实现了环比正增长。先进封装的需求增长驱动了SEMI板块的率先复苏,并有望成为公司2024年业绩修复的主要动力。
分业务毛利率来看,半导体毛利率较为稳定,维持在45%左右,23年Q3受半导体总体业绩影响有所下降,后两个季度恢复。SMT具备比较稳定的毛利率表现,后期有增长趋势。

营收结构分地域来看,2023年公司主要下游市场包括中国大陆(30.52%),欧洲(28.49%),美洲(18.37%),马来西亚(6.16%),韩国(3.3%),中国台湾(3.43%)。
公司在亚洲、欧洲和美洲设有多个研发中心,每年投入大量资金用于研发,强劲的研发基础设施及能力能够及时为主流和先进封装提供创新的解决方案,研发重点专注在机械、运动、电子、软件和视觉应用的五个关键领域,以期建立核心竞争力。2021-2023年研发费用由19.54亿港元增长至20.48亿港元,研发费用率从8.9%增长至13.93%。
2SEMI业务:算力先进封装设备领军者
2.1半导体封装设备全球份额第一
半导体封装设备有可观的市场空间。据SEMI数据,2022年全球半导体封装设备市场规模57.8亿美元,约占半导体设备整体规模的5.38%。SEMI预计2025年全球封装设备市场规模将达59.5亿美元。
封装设备种类繁多,包括固晶、焊线、塑封、切筋、电镀、测试等设备,其中die bond(固晶)和wire bond(焊线)是最为主要的两种设备,ASMPT在两类产品均有领先的市场份额。
固晶设备领域,据Yole Development数据,2018年ASMPT全球市场份额31%,为全球份额第一,主要竞争对手为荷兰的BESI。在焊线设备领域,据华经产业研究院数据,2020年ASMPT在中国市场份额30%位列第二,主要竞争对手为美国的K&S。
两类主要产品之外,ASMPT还有诸多其他封装环节的设备产品线。公司在发展过程中经历过数次战略性并购,每一次并购对公司巩固原有产品线市场地位、扩展自身产品线,跨领域业务拓展及前沿技术储备均具备明显效果。2011年收购西门子旗下的表面贴装业务SEAS进军SMT业务,2014年收购ALSI公司,购进激光与开槽设备,补充晶圆切割业务,完善封测设备的产品线。
2.2先进封装是主要增长动力
如前所述,封测市场需求呈现周期性波动特征,但其中先进封装则属于快速成长的新增量。
受益于AI算力硬件图形处理器(GPU)、中央处理器(CPU)、神经处理单元(NPU)、高带宽存储(HBM)等需求驱动,先进封装市场规模快速增长,据yole数据,2022年先进封装整体市场规模443亿美元,在生成式人工智能的推动下,预计2022年至2028年将以10.6%的复合增长率增长至786亿美元。
ASMPT在先进封装设备方面有广泛布局和领先的市场地位,能为先进封装流程提供一系列设备产品线。公司的热压式固晶(TCB)广泛应用于各种先进逻辑存储芯片;混合键合式固晶(HB)用于CIS和3D NAND堆叠等应用的晶圆到晶圆混合键合,以及HPC和数据中心的逻辑存储器3D堆叠;Fan-out固晶适用于2.5D、扇出和嵌入式应用;覆晶(FC)高精度固晶亦在AI算力芯片中取得应用。
其中TCB设备是公司在算力类芯片2.5D/3D封装领域的核心产品和优势项目,亦是对传统倒装固晶(FC)的升级。传统固晶设备仅实现芯片的取放,需要通过后续的回流焊工艺完成芯片的焊接,而TCB设备则在取放芯片的同时,进行加热和加压,一步实现了芯片的放置和键合。
公司TCB产品已经应用于头部晶圆代工厂C2S和C2W工艺,并导入头部HBM厂商用于12层HBM堆叠。
2023年先进封装解决方案占ASMPT营收的22%,约4.1亿美元(31亿港币),对应全球先进封装设备市场份额24%,公司预计其可触达的先进封装设备市场规模将从2024年的约17亿美元逐步扩大到2028年的33亿美元,年均复合增长率约为18%。潜在市场规模及其年均复合增长率的增长主要是受全球人工智能市场的急剧增长所推动。
算力芯片相关的先进封装有望成为公司近年的主要成长方向,包括AI GPU的2.5D/3D封装,HBM颗粒的3D叠封。下文我们将就公司在两方面的进展分别讨论。
2.3算力芯片封装:ASMPT实现广泛的工艺覆盖
人工智能技术等高性能计算的应用场景不断拓宽使得数据中心对高算力的GPU芯片的需求急速增长,从而拉动了先进封装及Chiplet工艺的需求。当前全球AI GPU类产品均采用2.5D/3D封装工艺。晶圆代工龙头台积电是Chiplet工艺的全球领先者,同时也是当前业内主流算力芯片厂商的主要供应商。台积电2021年将2.5D/3D先进封装相关技术整合推出3DFabric平台,旗下拥有面向算力硬件的CoWoS(2.5D)、SoIC(3D)封装,以及面向消费类产品的InFO封装。
在算力芯片的2.5D/3D封装中,在SOC之间、SOC与interposer之间(C2W)、interposer与封装基板之间(C2S),多道工序均需要固晶或键合设备,ASMPT在各环节均有产品线布局和应用导入。
(1)倒装固晶(FC)
高精确FC固晶是ASMPT的传统优势项目。应用在云端和数据中心的生成式人工智能和高性能计算需要不同程度的间距和配置精度。公司已与领先晶圆代工、HBM厂商和OSAT客户就C2W及C2S应用展开合作。
(2)热压焊接(TCB)
相比FC设备,热压焊接在相同的IO间距下可以实现更好的电气特性,可以实现更小的IO间距,并可以改善芯片键合的翘曲问题,因此在算力芯片2.5D/3D封装的C2W和C2S环节已经逐步替代FC。公司当前TCB产品已经导入全球领先的晶圆代工厂和OSAT厂商,根据公司2023年报披露,公司在2023年下半年获得晶圆代工客户C2S应用的重要TCB订单,已经开始交付,预期2024年第二季度获得更多来自该客户及其供应链合作伙伴的TCB订单。此外,公司也向该晶圆代工客户交付了下一代超细间距TCB用于C2W工艺。
(3)混合键合(HB)
混合键合是ASMPT正在开发中的新技术,通常用于芯片的垂直(或3D)堆叠,其显著特点是无凸块,它从基于焊料的凸块技术转向直接对铜对铜连接,意味着顶部die和底部die彼此齐平。两个芯片都没有凸块,只有可缩放至超细间距的铜焊盘,没有焊料,避免的了与焊料相关的问题。因此,混合键合互联方案可以显著降低整体封装的厚度。在算力芯片的3D封装中,SOC与SOC之间的3D堆叠通常采用HB工艺。
根据公司2023年报披露,2023年ASMPT的混合键合设备首次获得用于3D集成的2台订单,并将于2024年下半年交付。下一代混合键合设备亦与主要客户合作开发中。
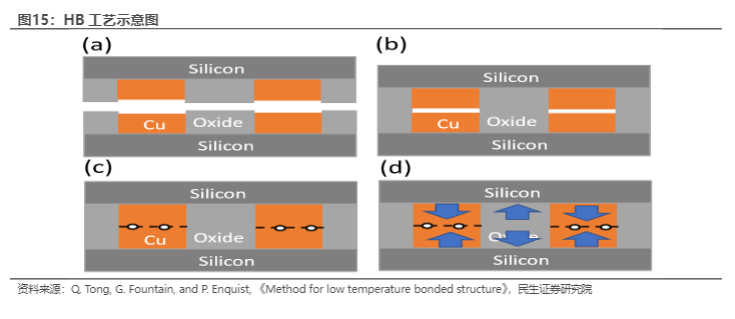
2.4HBM封装:技术标准变革,TCB需求持续
HBM(High Bandwidth Memory)指高带宽存储器,是一款新型的CPU/GPU内存芯片,基于2.5D/3D封装技术将DRAM Die垂直堆叠,具备高带宽、高速度等特点。DRAM Die之间通过TSV(硅通孔)的方式连接,逻辑控制单元对DRAM进行控制,GPU和DRAM之间通过u Bump和Interposer(起互联功能的硅片)连通,在制造环节,HBM相较传统DRAM增加了TSV、晶圆级封装等先进封装需求,尤其是对3D堆叠的封装尺寸有较高要求。
HBM历经多次处理器速度迭代,性能多维度提升,当前最新的HBM3E具有最高36GB的容量,大于9.2Gbps的带宽,和最高12层的堆叠层数。而据美光发布的产品路线图,下一代HBM4产品或将拥有最高16层堆叠和48GB容量。
当前HBM的主流方案为海力士的Advanced MR-MUF(批量回流模制底部填充)和三星、美光采用的TC-NCF(非导电膜的热压缩键接)两种。NFC是一种在芯片和芯片之间使用薄膜进行堆叠的方式,SK海力士从第三代HBM-HBM2开始采用这种方式。自SK海力士成功开发MR-MUF封装工艺技术后,海力士便从HBM2E开始从TC-NCF切换至MR-MUF。
但目前无论是哪种技术路径均有TCB需求。TC-NCF直接使用TCB进行堆叠,MR-MUF则是使用TC进行堆叠和pre-bonding,之后再进行MUF填充和Mass Reflow。作为全球TCB设备的龙头厂商,ASMPT受益于HBM市场的快速发展。
而在下一代HBM4时代,TCB需求仍有望持续。近期据ZDNet报道,JEDEC固态存储协会或将放宽HBM4在高度方面的标准,对12层/16层HBM4的厚度限制从上一代的720um放宽到775um。我们认为,若该行业标准落地,将对HBM封装设备的需求带来重大影响。可实现更薄封装厚度的混合键合技术导入或将延后,现有的TCB封装设备需求有望在下一代HBM4时代持续。
ASMPT凭借先发优势,TCB解决方案在市场中处于领先地位,拥有全球最大的已安装工具基础,其TCB客户群已经从逻辑垂直整合制造商拓展至高频宽存储芯片(‘HBM’)、领先晶圆代工及OSAT,并嵌入上述客户群的生成式人工智能供应链。在高频宽存储芯片市场方面,公司的TCB工具已经和一家领先的高频宽存储芯片公司合作投入生产,并继续与多家高频宽存储芯片客户进行重要合作。此外,随着高频宽存储芯片封装要求日趋严格,越来越多的工序将使用TCB,公司将凭借下一代超微间距TCB为12H/16H高频宽存储芯片满足市场需求。
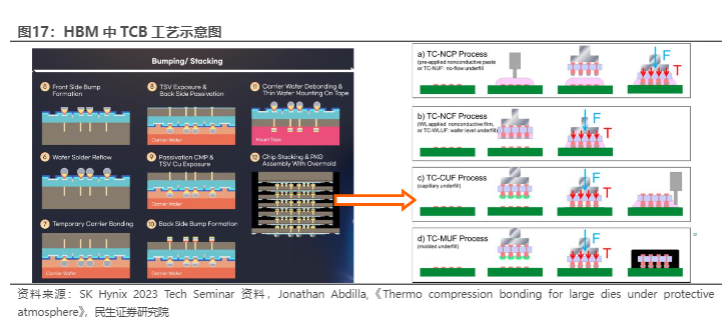
本文仅供参考,不代表我们的任何投资建议。如需使用相关信息,请参阅报告原文。