2024半导体封装基板行业分析报告
1. Ibiden:封装基板领军企业
1.1. 封装基板领军企业,技术转型驱动公司业务发展
Ibiden是全球前三大封装基板制造商,高端PC、服务器CPU类封装基板(FCBGA),Ibiden工艺技术占绝对优势。IC封装基板是芯片封装环节的核心材料,在中低端封装中占材料成本的40~50%,在高端封装中占70~80%。具有高密度、高精度、高性能、小型化及薄型化等特点,与晶片、引线等经过封测后共同组成芯片。
从历史沿革来看,Ibiden是通过技术转型驱动公司业务发展。公司1912 年成立,最初为电力企业,后利用发电进入了电炉业务,转型成制造型公司。1960年,日本进入经济高速增长期,公司又进入了建材行业。1973 年石油危机后建材业务受到冲击,公司基于高温烧成技术、电镀技术开发了印制电路板(PCB)。1988年开始在河间工厂生产IC 封装基板,后在多个日本国内工厂制造IC 封装基板,2000年公司进入了下一个100年的成长周期。
分业务看:FY2023公司封装基板收入占比51%,陶瓷业务收入占比26%,其他业务(建筑、电力等)收入占比22%。从公司未来成长角度看,2022-2024年封装基板占资本开支比重均超90%,是公司核心的成长动力。
公司封装基板业务主要是ABF载板,应用于PC、数据中心的CPU,以及应用于AI和汽车的GPU。Ibiden在此方面可实现超细布线的导体图案化技术,专注于SAP(半增材工艺),提供世界一流的微图案,也正在推动未来半导体图形化技术的发展。随着半导体技术的进步,对处理器运行速度更快、功耗更低提出了更高的要求,特别是在AI系统和数据中心服务器方面。为了满足这些需求,IC封装基板上的IC芯片(I/O)数量显著增加,技术规格也变得越来越具有挑战性,具有更加高性能的高层板(>22L)以及大尺寸基板(>100mmSQ)是未来发展趋势,公司在层数与面积上技术领先。Chiplet作为一种异构集成形式,极大地发挥出了3D架构的优势,可以注意到多条2D到3D的技术升维之路,纷纷指向了Chiplet。公司已经具备了为2.5D/3D先进封装为Chiplet主流封装技术。
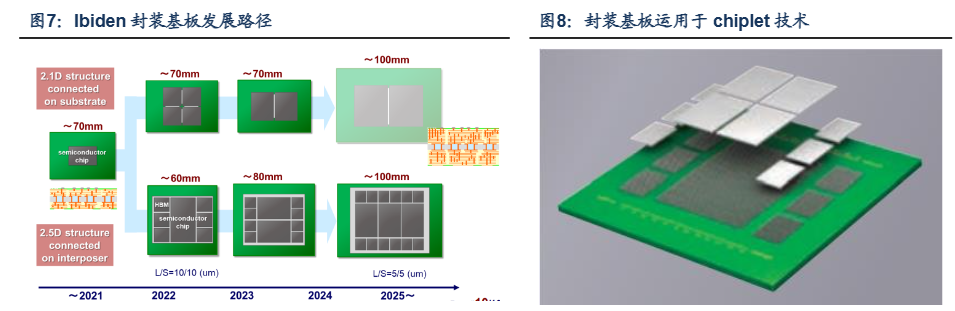
Ibiden下游客户主要由半导体龙头公司构成,英特尔是第一大客户,收入占比超三成,其他半导体龙头包括AMD、三星、台积电、英伟达等,汽车客户包括丰田、本田、电装、铃木等。
Ibiden在2021年5月宣布称投资1800亿日元(约人民币117亿元)用于建造新工厂,预计2025年扩充产能约40%,应对英特尔下一代服务器Birch Stream的需求。通过拆解和改造现有的河间工厂(日本岐阜县大垣市),在2023年中期启动新厂房(Cell 6)的运营。2023年6月Ibiden出售北京工厂给兴森科技公司,专注核心ABF载板业务的发展。2024年2月28日,为应对需求增加,Ibiden宣布发行7年期700亿日元(合33亿元人民币)的可转换公司债券(Convertible Bonds,CB),用于建设高性能半导体封装基板工厂以扩大产能。Ibiden表示,半导体需求经历了增长放缓,但随着个人电脑库存调整,数字化转型(DX)和AI应用的进化,由此带来的云计算服务的普及和数据存储需求的不断增长,数据中心对单一服务器的需求可能会显著增加。更强大的处理器、存储技术的改进以及高效的散热解决方案,这都会刺激高性能半导体封装基板的投资意愿,其具体应用包括用于PC和数据中心的MPU、用于AI和车辆的GPU(图像处理)。由于AI对芯片数据处理能力提出了更高的要求,IC封装基板正在往更大、更细、以及高阶2.5/3D路径发展。Ibiden为此制定了一个技术路线图,预计到25年封装基板尺寸将大于100mm。为了顺应行业的大趋势,Ibiden未来研发方向以3D堆叠封装,以及玻璃基板材质为主要方向。同时,Ibiden加入了台积电领导的联盟“台积电3DFabric联盟”,并将利用台积电的开放创新平台(OIP)生态系统和3Dblox标准,将先进工艺芯片所需的IC板产能提高到现有容量的十倍。
1.2. ABF载板业务扩张驱动公司成长,三重壁垒巩固行业龙头地位
Ibiden2018年以来不断对ABF基板业务进行产能扩张。2018年投入700亿日元扩建大垣中央工厂和大垣工厂,2020年投入600亿日元至大垣中央工厂,2021年开始投资1800亿对河间工厂进行产线升级改建。载板业务的扩张提高了公司综合水平的收入增速和盈利能力。FY2018-FY2022,电子业务(封装基板)收入增速CAGR为21.3%,总收入增速CAGR为9.4%。电子业务收入占比从FY2018的40%提升至FY2022的60%。从营业利润来看,FY2018Ibiden扩产ABF载板以来,电子业务大幅提高营业利润率的同时贡献了绝大部分利润来源。FY2018-FY2022,电子业务营业利润CAGR增速为121.2%,总营业利润增速CAGR为63.5%。电子业务营业利润占比从FY2018的25%提升至FY2022的84%。2023年由于疫情后PC和通用服务器需求的减少,加上前一轮行业扩产高峰带来的价格竞争压力,导致FY2023公司营收下降11.3%至3,705亿日元,营业利润下降34.1%至476.9亿日元。但是从结构来看,生成式AI服务器订单情况良好,增速显著。
封装载板由于直接和裸芯片相连,其制造存在资金(大)、技术(难)、客户(慢)三重壁垒:1)资金壁垒:封装基板生产工艺复杂,对生产场地及设备投资规模要求高,资金需求量大且投资回报周期长。2)技术壁垒:封装基板根据基材材质、层数、线宽/线距、手指中心间距等核心参数的区别,需要选择不同生产设备和工艺路线,定制化程度非常高,整个生产过程涉及材料学、光学、化学、电磁学、自动化控制、检测等众多跨专业学科,以及几十甚至上百道工序。
3)客户壁垒:封装基板作为芯片的核心材料,其产能、品质、交期等都直接影响到下游客户制造芯片的性能、良率与效率。因此,下游客户为保证自身产品质量、生产效率和供应链的安全性,对封装基板供应商通常采用“合格供应商认证制度”。Ibiden是封装基板三重壁垒的典型代表。2018年封装基板业务扩产以来,电子业务资本开支从2018的142亿日元增长到2023年的1369亿日元,CAGR为57.4%,对对比电子业务的收入比重,从2018年的12%提升到了2023年的72%。公司需要不断通过投入来巩固技术壁垒来绑定客户。高资本投入也带来了高折旧压力,2018年以来载板业务的大幅扩产让公司电子业务折旧摊销在FY2019-FY022年大幅增长,对比电子业务的收入比重,从2018年的12%提升到了2023年的19%。020 年后市场需求快速增长,Ibiden电子业务展现出较好的盈利能力,折旧也不再是电子业务的拖累项,但是2023年行业下行期间折旧对公司整体的业绩产生了较大的压力。
2. ABF载板业务深度受益AI需求
2.1. ABF载板受益AI带动的先进封装需求
ABF载板是以ABF树脂作为基材的封装基板,主要应用于CPU、GPU和晶片组等大量高端芯片,具有引脚数量多,传输速率高的特点。根据中国台湾电路板协会统计,2022年全球ABF封装基板产值约为96.6亿美元,占整体封装基板产值约54.1%。Ibiden占比14.6%为全球第二,仅次于欣兴电子(26.6%)
从ABF载板下游市场规模来看,PC用IC芯片仍然是ABF载板用量最大的下游市场,服务器/交换机、AI芯片以及5G基站芯片ABF用量逊于PC,但增长更快,是未来ABF基板增长的主要动力。预计2023年ABF载板PC端用量占比达47%,服务器/交换器、AI芯片和5G基站用量占比分别为25%、10%和7%。从ABF载板上游来看,ABF树脂是ABF载板的重要原材料,由Intel主导研发,日本味之素占据了很大部分的市场份额,占有超过98%的市场份额,根据味之素披露数据以及其扩产节奏,预计2021-2025年ABF树脂出货量的复合增速约为16.08%。
Chiplet封装技术的崛起进一步推动ABF载板需求。Chiplet意为芯粒,通过将系统级芯片SoC按照不同功能拆分为不同大小和性能的小芯片。不同的模块,比如CPU、存储器、模拟接口等,可以采用不同的工艺分别进行生产。Chiplet可以通过MCM、InFO、CoWoS、EMIB等多项封装技术实现,核心技术主要由台积电、日月光、英特尔等全球半导体龙头厂商主导,横跨2D至3D等多个级别的封装技术。Chiplet市场规模2035年有望达到570亿美元。根据Omdia的数据,Chiplet的市场规模在2018年仅有6.45亿美元,2024年预计可以达到58亿美元,2018-2024年复合增速约为44%;同时Omdia预计Chiplet市场规模在2035年有望达到570亿美元,2024-2035年复合增速约为23%。
通过chiplet封装技术,将来自不同制程、不同材料的个别芯片设计置于中介层基板之上的异质整合技术,要将这些芯片整合在一起,需要更大的ABF载板来放置。换言之,ABF载板耗用的面积将随chiplet技术而变大,而载板的面积越大,ABF的良率就会越低,ABF载板需求也会进一步提高。根据工研院数据,ABF载板将从2023年的供过于求5%,2024年、2025年逆转为供不应求,供给缺口将达5%、8%。
据兆丰国际汇整预测,PCCPU中,2022~2025年PCCPU/GPUABF消耗面积分别约为11.0%和8.9%CAGR,CPU/GPU2.5D/3D封装ABF消耗面积则分别高达36.3%和99.7%CAGR。
服务器中,兆丰国际汇整预测2022~2025年CPU/GPUABF消耗面积约10.8%和16.6%CAGR,CPU/GPU2.5D/3D封装ABF消耗面积约48.5%和58.6%CAGR。
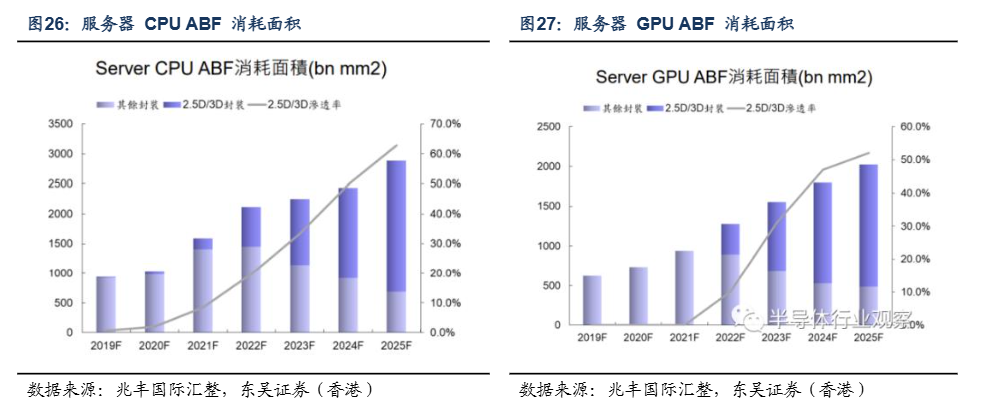
2.2. AI服务器:大算力芯片向先进封装迈进驱动ABF载板需求成长
大算力芯片向先进封装迈进将成为ABF载板需求成长的主因。Gartner预计,2023 年AI 芯片市场规模将达到534 亿美元,比2022 年增长20.9%,2024 年将增长25.6%,达到671 亿美元。到2027 年,AI 芯片营收预计将是2023 年市场规模的两倍以上,达到1194 亿美元。
AI服务器及AI芯片需求同步看涨,TrendForce集邦咨询预估2023年AI服务器(包含搭载GPU、FPGA、ASIC等)出货量近120万台,年增38.4%,占整体服务器出货量近9%,至2026年将占15%,2022~2026年AI服务器出货量年复合成长率至29%。
TrendForce集邦咨询表示,NVIDIA GPU为AI服务器市场搭载主流,市占率约60~70%,其次为云端业者自主研发的ASIC芯片,市占率逾20%。TrendForce集邦咨询表示,NVIDIA市占率高的主要原因有三,其一,目前不论美系或中系云端服务业者(CSP),除了采购原有的NVIDIA的A100与A800外,下半年需求也将陆续导入H100与H800,尤其新机种H100与H800平均销售单价约为A100与A800的2~2.5倍,加上NVIDIA同时积极销售自家相关整机解决方案。其二,高端GPU A100及H100的高获利模式也是关键,由于NVIDIA旗下产品在AI服务器市场已拥有主导权的优势,据TrendForce集邦咨询研究,H100本身的价差也依据买方采购规模,会产生近5,000美元的差异。其三,下半年ChatBOT及AI运算风潮将持续渗透至各种专业领域(如云端/电商服务、智能制造、金融保险、智慧医疗及智能驾驶辅助等)的开发市场,同步带动每台搭配4~8张GPU的云端AI服务器,以及每台搭载2~4张GPU的边缘AI服务器应用需求渐增,预估今年搭载A100及H100的AI服务器出货量年增率逾5成。
从高端GPU搭载的HBM来看,NVIDIA高端GPU H100、A100主采HBM2e、HBM3。以今年H100 GPU来说,搭载HBM3技术规格,其中传输速度也较HBM2e快,可提升整体AI服务器系统运算效能。随着高端GPU如NVIDIA的A100、H100;AMD的MI200、MI300,以及Google自研的TPU等需求皆逐步提升,TrendForce集邦咨询预估2023年HBM需求量将年增58%,2024年有望再成长约30%。针对AI服务器,工研院IEK产科国际所分析师张渊菘表示AI服务器占比仍低,但以主流机种NVIDIA DGX A100硬体分析,GPU模组是核心零件,占整体PCB成本达八成,包括8颗GPU晶片、6颗NV Switch晶片,均以ABF载板封装。根据产业链调研,单颗CPU和GPU载板价值量均价为100美金,单片NVSwitch晶片价值量均价为30美金,综合单台NVIDIA DGX A100ABF载板价值量为1240美金。

2.3. 服务器:行业尚未恢复,核心客户技术路径迭代带动价值量提升
根据TrendForce集邦咨询最新研究显示,服务器整机出货趋势今年主要动能仍以美系CSP为大宗,但受限于通货膨胀高,企业融资成本居高不下,压缩资本支出,整体需求尚未恢复至疫情前成长幅度,预估2024年全球服务器整机出货量约1,365.4万台,年增约2.05%。
2023年,英特尔在数据中心研讨会上公布了2023-2025 年Xeon 至强CPU 路线图。英特尔宣布,将把至强系列分为P-Core 和E-Core 两个系列,前者就是之前的至强系列,后者是新增加的节能架构,将提供更好的电源效率。
针对观察到的情况,英特尔将引入下一代代号为Birch Stream的创新平台,该平台将支持两种不同类型的至强处理器,其一是主打高性能的下一代P-core性能核处理器Granite Rapids。其二是英特尔将推出的第一款基于E-core能效核的产品Sierra Forest。根据产业链调研Birch Stream平台ABF载板面积将较前一代的Eagle Stream扩大约六到七成。2024年上半年Sierra Forest处理器将会上市,它将是第一个使用Intel 3工艺制造的CPU。Sierra Forest处理器拥有144个核心,并且对云端工作的负载进行了专门优化,可以满足英特尔超大规模客户的需求。紧随Sierra Forest之后发布的是Granite Rapids处理器。Granite Rapids使用Intel 3工艺制造,采用Raptor Cove架构,预计拥有120个核心和240个线程。Granite Rapids将使用英特尔开发的MCR DIMM技术,支持DDR5-8800,带宽提升了80%。
2.4. PC:行业复苏趋势显现,AI PC带来结构性增长
2023年全球PC出货量同比降幅逐季度缩窄,24Q1同比增长5%。根据IDC数据,23年全球PC出货量同比降幅逐季度收窄,24Q1全球PC出货量同比增长5%,PC行业逐步走出下行周期,行业拐点出现。
根据Canalys预测,全球个人电脑市场正步入复苏之路,24年出货量有望同比增长8%。OEM、处理器制造商和操作系统供应商等领先玩家将在2024年密集推出具备AI功能的新机型。这些举措将会提振换机需求,其中商用领域尤为明显。这主要得益于Windows的更新周期,以及具备AI功能和采用Arm架构电脑的崛起。
Canalys预测24年AI PC渗透率约19%,到2027年渗透率超60%。随着x86 架构对AI能力的提升,Canalys预测2024H1将出现AI赋能模型浪潮。鉴于在2024年末推出的最新Windows操作系统将发布经AI强化后的功能,以及AI工具在商业和生产力软件的广泛应用,AI PC市场将在2025年和2026年有望实现快速增长。Canalys预测到2027年,AI PC全球出货量预计超过1.7亿台,在总个人电脑出货量的占比超60%,23-27年AI PC出货量CAGR达63%。
Intel联合软硬件产业链共同打造AI PC加速计划:英特尔在Innovation 2023大会上分享了AI PC使用案例后,日前宣布启动AI PC加速计划,通过这项全球创新计划,加速AI在整体PC产业的发展。这是一项全球创新行动计划,以加速AI在客户端计算产业的发展速度,预计到2025年将惠及上亿台PC。该计划旨在联结独立软硬件供应商,并充分利用英特尔在AI工具链、协作共创、硬件、技术经验等资源,尽可能最大限度发挥AI和机器学习应用的性能。细节方面,英特尔宣布将通过与超100家独立软件供应商合作伙伴的深度合作、集合300余项AI加速功能,在音频效果、内容创建、游戏、安全、直播、视频协作等方面继续强化PC体验。
AMD新CPU系列AI性能提升明显:AMD官方宣布,将于2024年3月21日在北京隆重举行一场名为“AMDAI PC创新峰会”的活动。届时,AMD董事会主席及首席执行官苏姿丰博士和众多AMD高层,将会携手产业链重量级嘉宾们,共同出席此次盛会,展示AMD AI科技的强大实力。2023年初,AMD发布的锐龙7040系列笔记本处理器率先集成了NPU AI硬件单元,打造了全新的Ryzen AI引擎,生态支持也逐渐铺开,与微软、Adobe、字节跳动、爱奇艺等巨头都有深入合作。2023年底,AMD又推出了新一代锐龙8040系列,NPU AI算力大幅提升了60%。进入2024年,锐龙8000G系列APU又成为第一款具备AI引擎的桌面级处理器。2024年,AMD预计还将推出代号Strix Point的下一代产品,升级XDNA 2架构的新一代NPU,AI性能猛增超过3倍。客户端、边缘和连接:英特尔分享了客户端产品的发展势头以及诸多边缘和网络互联产品的路线图更新,包括:英特尔®酷睿™Ultra处理器为生产力、安全性和内容创作提供了全新能力,并为企业焕新其PC设备提供了巨大动力。
(本文仅供参考,不代表我们的任何投资建议。如需使用相关信息,请参阅报告原文。)